입자 크기
표면 손상 없이 오염원을 제거할 수 있는 입자 크기 제어
입자 크기는 세정 성능과 표면 보호 사이의 균형을 결정하는 핵심 변수입니다. 입자가 너무 크면 표면에 불필요한 물리적 충격을 가해 미세 구조나 패턴을 손상시킬 수 있으며, 반대로 너무 작으면 오염원을 충분히 제거하지 못할 수 있습니다.
특히 미세 패턴이 형성된 반도체 표면에서는 오염 입자의 크기와 표면 구조를 고려한 입자 크기 제어가 필수적입니다. 정밀하게 제어된 입자 크기는 표면 손상 없이 필요한 수준의 세정 효과를 확보하는 데 중요한 역할을 합니다.






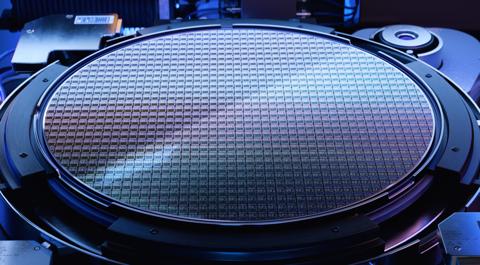


-demonstration-660x370.jpg?la=ko-KR&h=370&w=660&hash=C80A75C099E456EA270E5E4A94263E3A)
